底部填充封装点胶机带来哪些影响?
类别:行业动态 文章出处:欧力克斯发布时间:2019-10-12 浏览人次:


随着手机、电脑等便携式电子产品的发展趋向薄型化、小型化、高性能化,IC封装也趋向小型化、高聚集化方向发展。而底部封装点胶工艺可以解决精密电子元件的很多问题,比如BGA、芯片不稳定,质量不老牢固等,这也使得underfill底部填充工艺随着发展而更加受欢迎。
精密电子芯片元件会遇到哪些问题呢?
BGA和CSP是通过锡球固定在线路板上,存在热应力、机械应力等应力集中现象,如果受到冲击、弯折等外力作用,焊接部位容易发生断裂。此外,如果上锡太多以至于锡爬到元件本体,可能导致引脚不能承受热应力和机械应力的影响。因此芯片耐机械冲击和热冲击性比较差,出现产品易碎、质量不过关等问题。
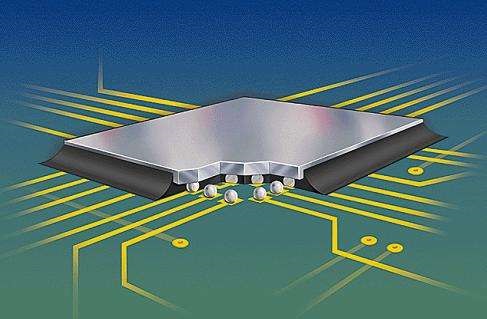
相关解决方案:
高精度的电子芯片,每一个元件都极其微细且关键,为了稳定BGA,需要多一个底部封装步骤,高精密点胶机非接触式喷射点胶机设备可实现精密芯片的底部填充封装工艺。随着技术的更新发展,和针对电子芯片稳定性和质量存在的问题,底部填充封装工艺便开始得到推广和应用,并获得非常好的效果。由于使用了喷射式点胶机进行underfill底部填充胶的芯片在跌落测试和高低温测试中有优异的表现,所以在焊球直径小、细间距焊点的BGA、CSP芯片组装中,都要使用底部填充胶进行底部补强。
底部填充封装点胶机带来的优势:
欧力克斯底部填充胶点胶机undfill封装应用,可以分散降低焊球上的应力,抗形变、耐弯曲,耐高低温-50~125℃,减少芯片与基材CTE(热膨胀系数)的差别,能有效降低由于硅芯片与基板之间的总体温度膨胀特性不匹配或外力造成的冲击。
非接触喷射点胶机底部填充工艺的应用,底部填充胶受热固化后,可提高芯片连接后的机械结构强度,使得产品稳定性更强!
更多底部填充封装点胶工艺和底部填充点胶机设备等相关信息,欢迎来访咨询欧力克斯。
同类文章推荐
- 机器视觉自动化重述未来
- 什么是物联网 (IOT)?
- 什么是数字制造?
- 什么是工业5.0?
- 5G 智能工厂 | 没有数字化转型战略的公司已经落后于竞争对手
- 5G与未来智能工厂:5G将如何影响工厂自动化
- 智能工厂的四个层次
- 现代汽车 | 智能工厂:创造性破坏带来的价值链创新
- 什么是工业 4.0?
- 什么是智能工厂?
最新资讯文章
您的浏览历史







